据麦姆斯咨询介绍,砂轮划片、激光全切等传统切割方式存在振动冲击大、切割屑污染、热应力作用大等问题,常常导致具有悬膜、悬臂梁、微针、微弹簧等敏感结构类型的芯片损坏。激光隐形切割技术通过将脉冲激光在材料内部聚焦,使得材料改性形成切割裂纹,适用于SOI晶圆、键合片、硅片、玻璃片、蓝宝石片等晶圆切割,是悬膜、悬臂梁等敏感结构类型MEMS器件的最佳切割方式。

激光划片工艺是利用激光能量代替机械力作为切割介质的划片工艺。激光隐形划片工艺为激光划片工艺的,其将激光聚光于晶圆内部,在晶圆内部形成改质层,并在完成划片后通过扩展胶膜等方法将晶圆分割成芯片的切割方法。该工艺原理为工件内部改质,因此可以抑制加工屑的产生,适用于抗污垢性能差的工件;切割过程无振动冲击,且采用干式加工工艺,无需清洗,适用于抗负荷能力差的芯片;切割道宽度要求低,有助于减小芯片间隔,适用于窄划片道器件。
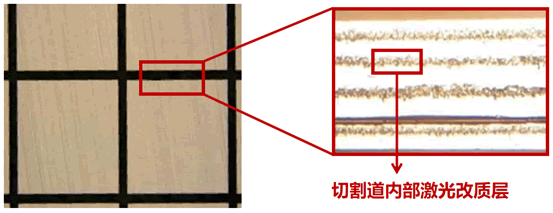
图1 切割效果图:晶圆厚度250um,激光隐切在晶圆切割道内部产生应力集中区域,断面图可清晰看到不同深度位置激光切割改质层痕迹。
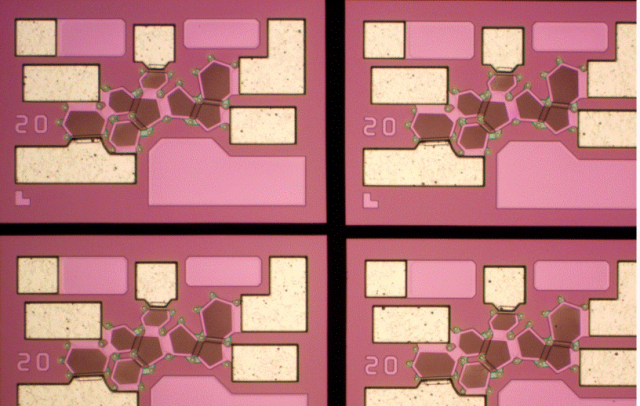
图2 切割效果图:激光隐切产生的切割屑极少,不污染器件,适用于梳齿结构、表面敏感类器件切割。
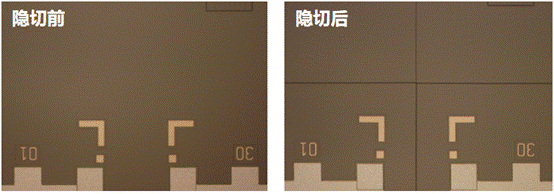
图3 切割效果图:晶圆厚度650um,切割道清晰,且无边缘切割毛刺,可用于更紧密的器件排列切割。
宁波启朴芯微系统技术有限公司拥有专业的激光隐形切割设备和技术解决方案,提供硅片、玻璃片、SOI、键合片等晶圆激光隐形切割技术服务。
工艺指标
● 加工范围:8英寸及以下;
●切割线宽:<3um;
●崩边范围:<5um;
●切割道预留宽度:>80um;
●晶圆厚度:50um~1000um;
●切割材质:硅、SOI、玻璃、石英、蓝宝石、键合片等。
审核编辑:刘清